2022-06-09
随着科技的发展,企业对高精度的产品要求及依赖越来越高,小到人们随处可见可用的手机,平板,音响大到飞行器,高铁汽车等都离不开芯片。而芯片的制造水平也是反应一个国家综合实力的缩影。为了防止有缺陷的晶片流入芯片后道封装工序,高精度的光学检测设备和检测手段非常必要。立仪科技研发的3D线共焦,采用国际领先的白光共焦技术,具备亚微米级别超高测量精度,可兼容多种不同材料,从镜面反射到漫反射、从透明材料到不透明材料均可适用,完美实现半导体封测阶段工件3D形貌测量,打破国外量测设备封锁,实现国产替代。可对物体3D形貌进行全场扫描,实现三维轮廓、平整度、粗糙度、高差、缝宽等检测和测量。
先进封装晶圆Bump三维形貌测量
晶圆级先进封装技术是行业发展的大趋势,该种类型晶圆表面3D精密测量和检测对产品质量的控制至关重要。通过高精度测量头可检测芯片是否存在设计缺陷或者制造过程导致的物理异常。熵智科技高精度线光谱光学探头,可用于测量晶圆bump高度、直径,bump的共面性,识别bump缺陷,例如缺失、偏移、短接等,可达到亚微米级的精密测量要求。

根据实际采集的点云数据,测量焊球高度重复测量误差±0.001mm
成品芯片BGA焊球三维形貌测量
细间距BGA封装芯片表面锡球具有非常高的尺寸及外形精度要求,以保证芯片贴装的精度和连接质量。立仪科技自研的3D线光谱共焦传感器,可对BGA焊球进行全场3D形貌扫描,实现芯片贴装表面三维轮廓精确测量,解析BGA焊球共面度、段高差、体积等几何信息。
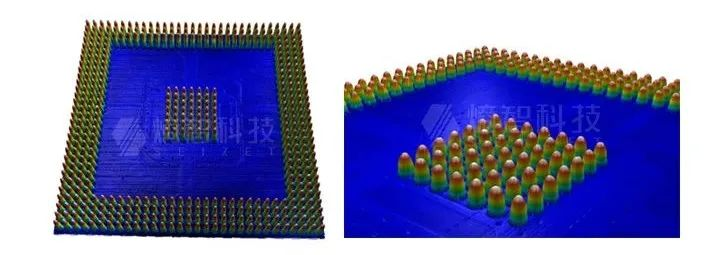
3D线光谱共焦传感器采集的BGA芯片3D点云图

截取剖面,两端的阶跃处为起始点和终止点,重复测量误差±0.005mm
PCB板孔深孔径三维形貌测量
印刷电子产品制造中高精度PCB板孔深孔径三维形貌测量是行业难题,立仪科技3D线光谱共焦传感器经实测可兼容不同基板材料印刷电路板,实现产品表面粗糙度测量,印刷结构台阶高度和宽度测量,深孔形貌测量等,同时传感器可适应有光泽的、光滑的和透明的材料(如玻璃或聚脂薄膜),实现快速准确的3D形貌成像。
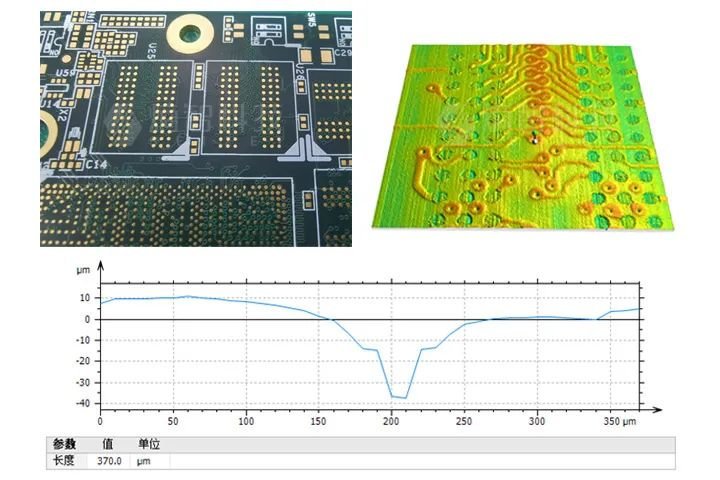
经比对,PCB板孔深重复测量误差可达±0.002mm,满足实际测量要求
深圳立仪科技有限公司,成立于2014年,是一家以精密光学检测为主业的民营高科技企业,专业生产及销售线光谱共焦位移传感器,激光位移传感器,白光干涉仪,膜厚仪,成立近10年的,为数百家企业解决了测量难题。



